A Novel Architecture for On-Device AI in Mobile Application with Enhanced Heat Dissipation
초록
실리콘 노드의 지속적인 미세화와 온디바이스 AI 기능의 확대는 모바일 기기에서 고용량 메모리와 고성능 애플리케이션 프로세서(AP)에 대한 수요를 증가시키고 있습니다. 그러나 최신 Gate-All-Around(GAA) 공정을 적용한 모바일 AP의 경우, AP 패키지 상단에 메모리 패키지를 적층하는 기존 POP(Package on Package) 구조에서는 이러한 고성능 공정의 성능을 충분히 발휘하는 데 한계가 존재합니다.
이에 삼성은 Fan-Out Wafer Level Package(FOWLP) 기술을 기반으로, 제한된 AP 패키지 상부 면적에 메모리와 Heat Path Block(HPB)을 비대칭 이종 집적한 새로운 패키지 플랫폼을 제안합니다. 이 혁신적인 구조는 2024년부터 삼성 모바일 AP 패키지에 적용된 양면 RDL(Double-Sided RDL) 기술을 통해 구현 가능했으며, 이를 통해 메모리와 HPB를 전략적으로 배치할 수 있는 설계 유연성이 확보되었습니다.
메모리 패키지, HPB 및 AP 칩으로부터 발생하는 얇은 RDL층에 대한 응력은 유한요소해석(Finite Element Analysis, FEA)과 사내 시뮬레이션 도구를 통해 최적화되었으며, Test Vehicle(TV) 평가를 통해 취약한 설계를 재조정하였습니다. 또한 POP 구조에서 주요 과제였던 워페이지(Warpage) 문제는 메모리 및 HPB 배치, 패키지 치수, 재료 특성 등 구조 요소 전반을 재설계함으로써 해결하였습니다.
본 구조는 패키지 레벨 신뢰성(PLR) 및 보드 레벨 신뢰성(BLR) 테스트를 모두 통과하여 기계적 및 전기적 신뢰성을 입증하였습니다. 또한 메모리 재배치와 HPB 추가를 통해 시뮬레이션과 Thermal Test Vehicle(TTV) 평가에서 열저항이 20% 이상 개선되는 효과를 확인하였습니다. 모바일 세트 환경에서의 열 분석과 TTV 결과 간 상관성 역시 검증되었습니다.
이와 같은 혁신적인 패키지 아키텍처는 차세대 모바일 패키징 기술의 발전을 견인할 것으로 기대되며, 다가오는 온디바이스 AI 시대의 핵심 돌파구가 될 것으로 예상됩니다.

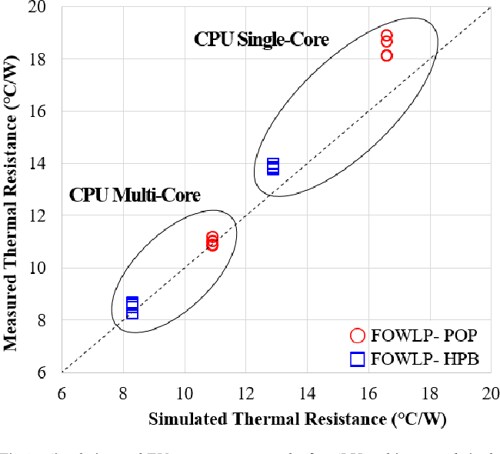
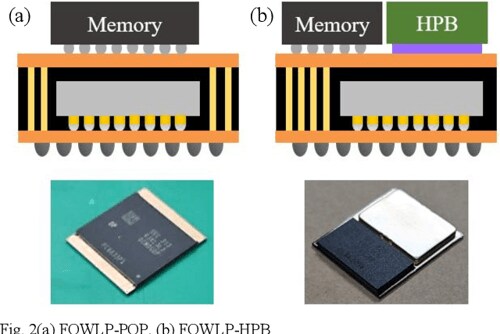
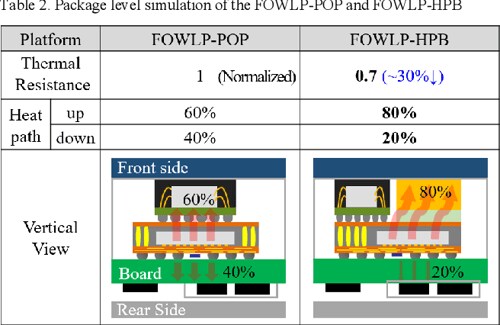

(IP보기클릭)118.235.***.***
(IP보기클릭)1.214.***.***
(IP보기클릭)211.214.***.***